Abstract
Combining the knowledge-based processing with image processing is considered a key issue in the future of visual inspection of complex patterns such as multilayered semiconductor wafers. However, present technology restricts this combination, mainly because of the exhaustively long time usually required for each type of processing. To cope with this situation, a unique knowledge-directed image processing method is proposed, in which every image processing step is controlled in real time by parametric knowledge driven by design patterns. The resulting structure of the image processor is a pipeline, in which each piece of knowledge is embodied as a combination of a hardware processing unit and control unit. In this paper the types of knowledge and their implementation are explained, and an inspection machine for logic IC wafers based on this pipelined knowledgedirected image processing is introduced.
Similar content being viewed by others
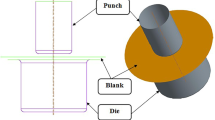
References
Awamura D, Nakashima K (1984) Defect inspection techniques for LSI wafer. Semiconductor World 3(6): 112–119 (in Japanese)
Bruning JH, Feldman M, Kinsel TS, Sittig EK, Town-send RL (1975) An automated mask inspection system-AMIS. IEEE Transactions on Electron Devices ED-22(7):487–495
Dom B et al. (1988) The P300: A system for automatic patterned wafer inspection. Machine Vision and Applications 1:205–221
Ejiri M (1984) Views on robotics for future industry. In: Proceedings of Second International Symposium on Robotics Research, pp 166–172
Ejiri M, Uno T, Mese M, Ikeda S (1973) A process for detecting defects in complicated patterns. Computer Graphics and Image Processing 2(3/4):326–339
Fusek RL, Harding K, Gustafson S. (1985) Holographic optical processing for submicrometer defect detection. Optical Engineering 24(5):731–734
Goto N, Kondo T, Ichikawa K, Kanemoto M (1978) An automated inspection system for mask patterns. In: Proceedings of Fourth International Joint Conference on Pattern Recognition, pp 970–974
Hara Y (1987) Automating inspection of aluminum circuit patterns of LSI wafers. Electronics and Communication in Japan Part 2. 7(3):46–58
Hara Y, Akiyama N, Karasaki K (1983) Automatic inspection system for printed circuit boards. IEEE Transactions on Pattern Analysis and Machine Intelligence PAMI-5(6):623–630
Harris KL, Sandland P, Singleton RM (1983) Wafer inspection automation: Current and future system. Solid State Technology 26(8): 199–205
Harris KL, Sandland P, Singleton RM (1984) Automated inspection of wafer patterns with applications in stepping, projection and direct-write lithography. Solid State Technology 27(2): 159–179
Hsieh YY, Fu KS (1980) Automatic visual inspection of integrated circuit chips. Computer Graphics and Image Processing 14(4):293–343
Jarvis JF (1980) A method for automating the visual inspection of printed wiring board. IEEE Transactions on Pattern Analysis and Machine Intelligence PAMI-2(1):77–82
Konishi T, Misonou M, Katou T (1982) Surface defect inspection system for VLSI wafer. Journal of Institute of Television Engineers of Japan 36(1):38–44 (in Japannese)
Pau LF (1983) Integrated testing and algorithms for visual inspection of integrated circuits. IEEE Transactions on Pattern Analysis and Machine Intelligence PAMI-5(6):602–608
Yoda H, Ohuchi Y, Taniguchi Y, Ejiri M (1988) An automatic wafer inspection system using pipelined image processing techniques. IEEE Transactions on Pattern Analysis and Machine Intelligence PAMI-10(1):4–16
Author information
Authors and Affiliations
Rights and permissions
About this article
Cite this article
Ejiri, M., Yoda, H., Sakou, H. et al. Knowledge-directed inspection for complex multilayered patterns. Machine Vis. Apps. 2, 155–166 (1989). https://doi.org/10.1007/BF01212456
Issue Date:
DOI: https://doi.org/10.1007/BF01212456



